Полупроводниковые интегральные схемы. Технологические основы полупроводниковой микроэлектроники, Основные технологические операции по изготовлению ППИС - Основы микроэлектроники
Микросхема диэлектрический биполярный полупроводниковый
Полупроводниковая ИС - это микросхема, которая представляет собой кристалл полупроводника, в приповерхностном слое и объеме которого сформированы области, эквивалентные элементам электрической схемы и соединений между ними.
Основные технологические операции по изготовлению ППИС
1. Подготовительные.
Подготовительные монокристаллические слитки кремния обычно получают методом кристаллизации из расплава (метод Чохральского), при этом стержень с затравкой в виде монокристалла кремния после соприкосновения с расплавом медленно поднимают с одновременным вращением. Вслед за затравкой вытягивают нарастающий и застывающий слиток. Диаметр стержня 1,5-3 см, длина - до 3 метров (обычно 70-100 см). Затем слиток кремния разрезают на пластины толщиной от 0,5 до 4 см.

Перед началом основных технологических операций проводят шлифовку пластин для:
- 1) удаления механических дефектов; 2) обеспечения параллельности плоскостей; 3) обеспечения необходимой толщины пластин (0,15 - 0,25 мм).
После шлифовки проводят полировку пластин для снижения шероховатости поверхности до сотых долей микрона.
Проводят травление.
2. Эпитаксия.
Эпитаксия - это процесс наращивания монокристаллических слоев на подложку, при котором кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки.
Эпитаксия может быть:
1) Из газовой фазы.
Используется типовой хлоридный процесс. Монокристалл кремниевой пластины помещают в тигель в кварцевую трубу через которую пропускают поток водорода с небольшим количеством примеси тетрохлорида кремния SiCl4. При высокой температуре на поверхности кремниевой пластины проходит реакция:

.
В результате на поверхности пластины создается слой чистого кремния, а пары соляной кислоты удаляются с потоком водорода. Если к парам SiCl4 добавить B2H6 (гексогидрид бора) то сождаемая пленка будет иметь дырочный тип проводимости, если же PH3 (тригидрид фосфора) - электронный тип.
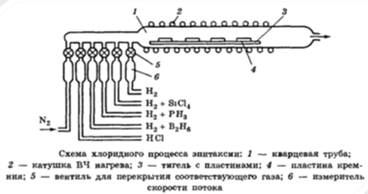
2) Из жидкостной фазы - методом Чохральского.
Для улучшения контроля процесса применяют электроэпитаксию - через выращиваемый граничный слой пропускают электрический ток, при определенной полярности происходит охлаждение (рост пленки) или нагрев граници раздела двух фаз (растворение верхнего слоя подложки в расплаве).
- 3) Молекулярно-лучевая эпитаксия - конденсация молекулярных пучков в сверхвысоком вакууме (аналог вакуумного напыления). 3. Термическое окисление.
Термическое окисление кремния - один из самых характерных процессов в полупроводниковой технологии изготовления ИМС. Пленка диоксида выполняет следующие функции:
- 1) защитная (пассивация, изоляция поверхности); 2) маскирование; 3) функцию тонкого диэлектрика под затвором МОП транзистора (МДП).

Окисление кремния проводят при температуре от 1000? до 1200?С в атмосфере кислорода (сухое окисление) или смеси кислорода с парами воды (влажное).
4. Легирование (внедрение примеси).
Осуществляется либо в однозонных печах (если используется жидкий или газообразный источник диффузии) или в двузонных печах, если используется твердый источник диффузии. При этом в первой зоне диффузант примешивается к потоку нейтрального газа-носителя и переносится во вторую зону, где при более высокой температуре происходит диффузия.
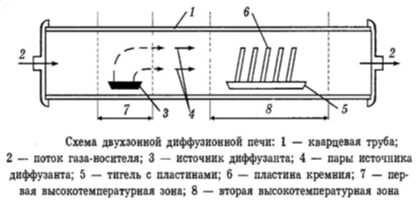
Теоретические основы диффузии базируются на законах Фика:
1)

D - коэффициент диффузии, N - концентрация, I - плотность потока частиц.
- 2) - характеризует скорость накопления частиц в кристалле или накопление атомов примеси на определенной глубине. Для того что бы рассчитать распределение примеси по глубине в любой момент времени необходимо задать граничные условия.
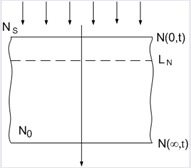
N(0,t) - концентрация примеси на поверхности.
N(?,t) - концентрация примеси на противоположной стороне подложки.
LN - глубина, на которую надо внедрить примесь.
NS - поверхностная концентрация.
N0 - собственная концентрация.
Ш Случай неограниченного источника диффузанта.

.

,
Где еrfc - дополнительная функция ошибок, близкая к экспоненциальной функции e-z.

.
Для создания p-n-перехода необходимо на глубине LN получить равенство концентраций внедряемой примеси и собственной концентрации кристалла:

.
Ш Cлучай ограниченного источника диффузанта.
Сначала в приповерхностный слой пластины вводят некоторое количество атомов диффузанта, затем источник диффузии отключают, повышают температуру и атомы примеси перераспределяются по глубине при неизменном их общем количестве.

Где Q - количество атомов примеси на единицу площади.

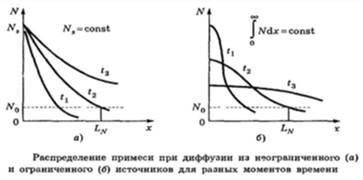
Ш Ионная имплантация.
Это метод легирования пластин путем бомбардировки атомами примеси, ускоренными до энергии достаточной для внедрения атомов вглубь твердого тела. Энергия атомов порядка 100-150 КэВ. Концентрация примеси в имплантированном слое зависит от плотности тока в пучке и времени процесса (он идет от нескольких минут до нескольких часов).
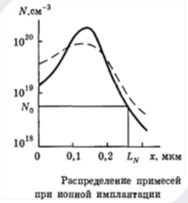
Преимущества:
- 1) низкая температура процесса; 2) контролируемость.
Недостатки: сканирование пучка.
- 5. Травление. 1) собственно травление - химическая реакция жидкого травителя с твердым телом с образованием растворимого соединения. В отличие от механического травления стравливание происходит плавно, один молекулярный слой следом за другим. Подбирая травитель, его концентрацию, температуру и время процесса регулируют толщину удаляемого слоя. 2) Электролитическое травление - процесс происходит в условиях протекания тока через жидкость. Твердое тело - анод. 3) Ионное травление - пластина помещается в вакуум, в нем создается тлеющий разряд, на кремний подается отрицательный потенциал и ионы плазмы бомбардируют пластину (травят). Энергия ионов - 2-3 кэВ. 6. Литография.
Литография - процесс создания или переноса геометрического рисунка (топологии) на поверхность подложки.
Бывает:
- 1) Фотолитография. 2) Электронная литография. В этом виде литографии сфокусированный пучок электронов сканирует поверхность пластины, покрытой резистом или диоксидом кремния. В тех местах, которые должны быть засвечены ток пучка максимальный. В местах засветки диоксид кремния травится быстрее. 3) Лазерная литография. Она основана на воздействии сканирующего луча эксимерного лазера на кремниевую подложку, помещенную в среду хлора. В результате химической реакции ионов хлора с атомами кремния при тепловом воздействии лазерного луча образуется газообразное соединение SiCO4, которое улетучивается, а на подложке образуется вытравленный участок. 7. Отжиг.
В основном для металлизация кремния используется алюминий. Если пленку алюминия просто напылить на поверхность кремния, то образуется барьеры Шоттки. На границе с n-областями появлятся выпрямляющие переходы. Чтобы этого избежать алюминий вжигают в кремний при температуре 600?С. При этом на границе алюминий-кремний образуется слой в котором растворен практически весь алюминий. После застывания получается приповерхностный слой кремния легированный алюминием с концентрацией 5-1013 см-3. Поскольку алюминий является акцептором по отношению к кремнию, то возможно образование p-n переходов в n-слоях. Чтобы этого избежать n-область вблизи контакта сильно легируют создавая n+ слой с концентрацией 1020 см-3.
Похожие статьи
-
Технология изготовления ППИС на БТ. Элементы ППИС необходимо изолировать друг от друга что бы необходимые соединения осуществлялись только путем...
-
Физика полупроводниковых структур - Основы микроэлектроники
В полупроводниках существует два основных механизма переноса носителей заряда: 1) Диффузия - направленное перемещение носителей заряда в кристалле в...
-
Микроэлектроника. Основные понятия. Микроэлектроника - это раздел электроники, охватывающий исследования и разработку качественно нового типа электронных...
-
Гибридные интегральные схемы - Основы микроэлектроники
Гибридная ИС (ГИС) - микросхема которая представляет собой комбинацию пленочных пассивных элементов и активных компонентов расположенных на общей...
-
Для бесперебойной эксплуатации вагонного парка и содержания его в исправном состоянии на железных дорогах России установлена четкая система технического...
-
Физические процессы в р-n-переходе Основным элементом большинства полупроводниковых приборов является электронно-дырочный переход (р-n-переход),...
-
В качестве заготовки для шестерни используем поковку, изготовленную на горячештамповочном кривошипном прессе. Существует ряд основных принципов...
-
Для производства Многослойных печатных плат используются различные стеклотекстолиты по условию технического задания устройство должно работать в условиях...
-
Полупроводниковые твердые схемы - Электроника и схемотехника аналоговых устройств
Твердые схемы представляют собой устройства, состоящие из кристаллов полупроводника, выполняющих функции активных и пассивных элементов схемы без внешних...
-
Дефект Способ устранения № операции Наименование и содержание операции Установочная база Износ шатунных шеек Износ коренных шеек Износ отверстий во...
-
Для целенаправленного изменения свойств полупроводники легируют, т. е. вводят в небольшом количестве атомы примесей, позволяющие управлять типом...
-
В авторемонтном производстве пневмоинструмент находит широкое применение для работ с силовым крепежом, а также для выполнения слесарно-сборочных,...
-
Изоляция диэлектриком., Комбинированные способы изоляции. - Основы микроэлектроники
1. EPIC-технология. Исходная пластина n-кремния покрывается эпитаксиальным n+-слоем, толщиной 2-3 мкм. Затем в пластине вытравливают канавки глубиной...
-
Само название "полупроводник" произошло от различия электропроводности полупроводников от электропроводности металлов и диэлектриков. Действительно Но...
-
При всем многообразии применяемых в производстве ремонтных операций все же многие из них можно сгруппировать в типовые группы с одинаковым...
-
Нанесение защитной пленки диэлектрика (Si02) - Электроника и схемотехника аналоговых устройств
После формирования кремниевой подложки наступает этап создания сложнейшей полупроводниковой структуры. Для этого в кремний нужно внедрить так называемые...
-
После формирования кремниевой подложки наступает этап создания сложнейшей полупроводниковой структуры. Для этого в кремний нужно внедрить так называемые...
-
Выбор материала шатуна Для изготовления шатуна бензинового автомобильного двигателя (n=6000 об/мин) выбираем в качестве материала шатуна сталь 18Х2Н4МА,...
-
Шаг 5. Травление - Характеристика процессоров различных архитектур
После засвечивания слоя фоторезиста наступает этап травления (etching) с целью удаления пленки диоксида кремния. Часто процесс травления ассоциируется с...
-
Поместить подложку на столик центрифуги. Нанести фоторезист, включить вакуумный прижим, включить центрифугу. Скорость вращения центрифуги 2500 об/мин,...
-
Простейший вид излучения - монохроматическое, т. е. излучение характеризуемое очень узким интервалом длин волн. 1- (1 при 0. Монохроматическое излучение...
-
Напыление слоя Cr-Al Включить вакуумную установку в соответствии с инструкцией по ее эксплуатации. Подготовить вакуумную камеру к напылению в...
-
Многогранность структуры авторемонтного производства, выполняемых работ и используемого технологического оборудования предопределяют многообразие видов...
-
Основные схемы включения операционных усилителей - Разработка дифференциального усилителя
Рассмотрим некоторые виды ОУ наиболее часто встречающиеся в линейных схемах. Линейность схемы определяется зависимостью входного и выходного сигнала т....
-
Припуском на обработку называется слой материала, удаляемый с поверхности заготовки в процессе ее обработки для обеспечения заданного качества детали....
-
Поместить пластину на столик центрифуги Нанести фоторезист (скорость вращения центрифуги 2000 об/мин, время вращения 1 мин); Сушить фоторезистивную...
-
Поместить подложку на столик центрифуги; Нанести фоторизист, включить вакуумный прижим, включить центрифугу. Скорость вращения центрифуги 2500 об/мин,...
-
Погрузить подложку в раствор с травителем (состав: хромовый ангидрид - 450 г; серная кислота 160 мл; дистиллированная вода - 450 мл). Произвести...
-
Элементы ППИС. - Основы микроэлектроники
1. Разновидность биполярных интегральных транзисторов. 1) Многоэмиттерные транзисторы. МЭТ - составляют основу класса цифровых схем ТТМ. Недостатки: Ш...
-
При устранении износа шеек под шариковый подшипник и восстановлении износа шлицев под фланец ведомого вала по толщине в качестве базовой поверхности...
-
В условиях авторемонтного производства большинство работ по монтажу и демонтажу деталей и агрегатов, замене технических жидкостей, регулированию систем и...
-
Технологический анализ чертежа Деталь - колесо зубчатое, изготовляется из легированной стали 45Х ГОСТ 4543-71 (С=0,41% ; Si=0,17% ; Mn=0,5% ; Cr=0,8%),...
-
В этом подразделе пояснительной записки необходимо выполнить планировку участка (отделения), имеющуюся на предприятии по месту практики. Планировка...
-
Основные типы полупроводниковых преобразователей электрической энергии - Типы преобразователей
К основным типам полупроводниковых преобразователей относятся: - неуправляемые и управляемые выпрямители, ведомые сетью инверторы; - импульсные...
-
Основные требования, предъявляемые при проектировании экипировочных устройств для локомотивов Экипировочные устройства для локомотивов сооружаются на...
-
Точностные параметры - Основные параметры линейных стабилизаторов напряжения
Основное назначение стабилизаторов - поддерживать выходное напряжение неизменным, равным номинальному значению в условиях изменяющегося входного...
-
Поместить подложку на столик центрифуги; Нанести фоторезист ФН-11, включить вакуумный прижим, включить центрифугу. Скорость вращения центрифуги 2500...
-
Детали оперения должны быть тщательно очищены и отремонтированы, наличие на деталях оперения следов коррозии, грязи и старой краски не допускается....
-
Исходными данными для разработки геометрической информации являются: - сборочные и детальные чертежи самолета (изделия); - электронные геометрические...
-
Фотография, наряду с книгой, кино, видео и магнитозаписью, лазерными дисками с помощью определенной системы кодирования составляют социальную память...
Полупроводниковые интегральные схемы. Технологические основы полупроводниковой микроэлектроники, Основные технологические операции по изготовлению ППИС - Основы микроэлектроники