Гибридные интегральные схемы - Основы микроэлектроники
Гибридная ИС (ГИС) - микросхема которая представляет собой комбинацию пленочных пассивных элементов и активных компонентов расположенных на общей диэлектрической подложке (активные компоненты являются навесными).
Главным элементом ГИС является подложка - конструктивная основа ГИС. К материалам подложек предъявляются следующие требования:
- 1) Высокое удельное сопротивление элементов 2) Механическая прочность 3) Физическая и химическая стойкость 4) Стойкость к высоким температурам 5) Хорошая полеруемость поверхностей 6) Невысокая стоимость
Материал подложки и технология изготовления должны обеспечивать высокий класс чистоты поверхности для обеспечения однородности и воспроизводимости электрических параметров схемных элементов.
Пассивными элементами называют резисторы, конденсаторы и катушки индуктивности. Активными элементами называют транзисторы, диоды и прочие элементы микросхем.
Пассивные элементы ГИС.
Резисторы.
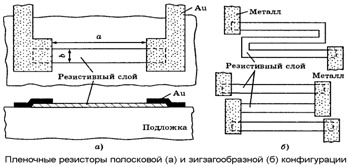
,




, , .

R-сопротивление; a-длина резистора; b-ширина резистора; h-толщина резистора; Kф-коэффициент формы; - удельное поверхностное сопротивление, характеризует сопротивление квадрата поверхности.
Конденсатор.
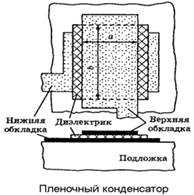


, .
C - емкость конденсатора; a-длина резистора; b-ширина резистора; S - площадь обкладки; d - расстояние между обкладками конденсатора.
Катушка индуктивности.

Методы формирования тонких пленок.
Существует 3 основных метода формирования тонких пленок:
- 1. Термическое вакуумное напыление; 2. Ионно-плазменное напыление:
- А) Катодное напыление; Б) Ионно-плазменное напыление;
Критерий необходимого вакуума - средняя длина свободного пробега атома должна в несколько раз превышать расстояние между испарителем и подложкой (10-11 - 10-12 мм рт. ст.).
Достоинства метода:
- 1) скорость напыления; 2) простота и отработанность технологии; 3) возможность получения чистых пленок из-за высокой степени вакуума.
Недостатки метода:
- 1) большой расход материала; 2) низкая адгезия (прочность сцепления пленки с подложкой или другой пленкой); 3) невысокое качество пленок из-за неравномерности напыления; 4) трудность воспроизведения химического состава испаряемого вещества; 5) трудность напыления тугоплавких материалов. 2. Катодное напыление. 1. Металлический или стеклянный колпак. 2. Опорная плита. 3. Прокладка, поддерживающая вакуум. 4. Подложка. 5. Держатель. 6. Катод изготовленный из напыляемого вещества. 7. Нагреватель. 8. Штуцер.
Катод 6 состоит либо из напыляемого вещества, либо электрически контактирует с ним. Роль анода выполняет подложка с держателем.
Подколпачное пространство сначала откачивается до 10-5 - 10-6 мм рт. ст., а затем вводят некоторое количество отчищенного нейтрального газа (часто аргон), создается давление 10-1 - 10-2 мм рт. ст. При подаче высокого напряжения (2 - 3 кВ) на катод, в пространстве анод-катод возникает аномальный тлеющий разряд, сопровождающийся образованием квазинейтральной электронно-ионной плазмы. В прикатодном пространстве образуется сильное электрическое поле. Положительные ионы газа, ускоряемые этим полем, бомбардируют катод, выбивая из него не только электроны но и нейтральные атомы. Катод разрушается, а нейтральные атомы осаждаются на подложку, формируя пленку.
Достоинства метода:
- 1) низкая температура; 2) небольшой расход напыляемого вещества т. к. напыление идет только на подложку.
Недостатки метода:
- 1) материал должен обладать высокой электропроводностью (невозможность напыления окислов и диэлектриков); 2) загрязненность пленок из-за не высокого вакуума; 3) низкая скорость напыления. 3. Ионно-плазменное напыление. 1. Металлический или стеклянный колпак. 2. Опорная плита. 3. Прокладка, поддерживающая вакуум. 4. Подложка. 5. Держатель. 6. Накаливаемый катод. 7. Анод. 8. Штуцер. 9. Мишень.
Между электродами 6 и 7 зажигается несамостоятельный дуговой разряд, характеризующийся специальным источником электронов в виде накаливаемого катода 6, низкими рабочими напряжениями (десятки вольт) и большой плотностью электронно-ионной плазмы.
Подколпачное пространство заполнено нейтральным газом с давлением 10-3 - 10-4 мм рт. ст.
На мишень подается отрицательный потенциал (2-3 кВ) достаточный для возникновения аномальный тлеющий разряд и интенсивной бомбардировки мишени положительными ионами плазмы. Выбиваемые атомы мишени попадают на подложку и осаждаются на ней.
Использование механической заслонки позволяет реализовать ионную отчистку мишени, что повышает качество напыляемой пленки.
По сравнению с катодным напылением у этого метода следующие преимущества:
- 1) большая скорость; 2) большая гибкость процесса; 3) более высокий вакуум (соответственно выше качества пленки). 4. Электрохимическое осаждение.
В основе метода лежит электролиз раствора содержащего ионы необходимых примесей. Ионы материалов в растворе имеют положительный заряд, поэтому подложку используют, как катод.
Достоинства метода:
- 1) большая скорость напыления; 2) возможность регулировки толщины получаемых пленок с помощью изменения тока.
Недостатки метода: очень низкое качество получаемых пленок.
Нанесение тонких сплошных пленок на поверхность подложки не является основной целью технологии, основная задача - создание требуемой топологии (геометрия рисунка). Для этого необходимо преобразовать сплошную пленку в соответствующий рисунок (изображение) удалив ненужные части.
Существует несколько методов формирования элементов ГИС:
- 1. Метод съемной маски; 2. Метод контактной маски.
Метод съемной маски.
Метод съемной маски основан на осаждении пленок через маски. Маска представляет собою тонкую биметалическую фольгу с отверстиями (окнами).
Недостатки метода:
- 1) в процессе происходит напыления на сами трафареты и приводит их в негодность; 2) провисание трафаретов; 3) металлические маски мало пригодны при катодном и ионно-плазменном напылении так как искажают электрическое поле, что влияет на скорость напыления.
Метод контактной маски.
Процесс создания или переноса геометрического рисунка (топологии) на поверхность подложки называют литографией.
Для формирования изображения на поверхности применяются специальные материалы называемые резистами (чувствительные к активному излучению материалы наносимые центрифугированием или пульверилизацией на подложку). После обработки активным излучением пленка резиста претерпевает физико-химические изменения в следствии которых становится устойчивой к воздействию агрессивной среды. Ненужные части пленки удаляют так называемым проявителем. Оставшийся рисунок называют маской.
Если после взаимодействия с активным излучением материал резиста разрушается и после может быть удален такой резист называют позитивным. Если же полимеризуется и преобретае трехмерную структуру, а необлученный материал может быть удален, то такой резист называют негативным.
Литография использующая в качестве активного излучения электромагнитные волны видимой и УФ области излучения называется фотолитографией.
Фотолитография.
Рисунок будущей маски изготавливают в виде так называемого фотошаблона. Фотошаблон - толстая стеклянная пластина на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий.
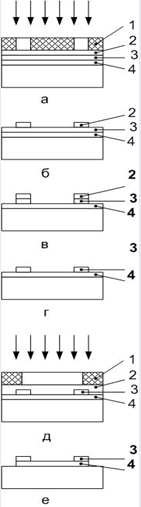
Получение тонкопленочного резистора методом фотолитографии представлено на рисунке слева, где 1 - фотошаблон, 2 - фоторезист, 3 - проводящий слой, 4 - резистивный слой.
Фотолитографию осуществляют следующим образом. На подложку наносят сплошные пленки необходимых материалов, например, для создания резистора, резистивный слой и поверх него - проводящий (а). Затем поверхность покрывают фоторезистом и с помощью соответствующего фотошаблона создают в нем рисунок проводящего слоя (б), проводят травление для удаления ненужных частей проводящего слоя (в), оставшийся фоторезист удаляют (г). В результате на пока еще сплошной поверхности резистивного слоя получают готовые контактные площадки. Снова наносят фоторезист и с помощью другого фотошаблона создают рисунок полоски резистора (д). Затем проводят травление, удаляют фоторезист и получают готовую конфигурацию резистора с контактными площадками(е).
Материалы, применяемые в изготовлении ГИС.
Для резистивных пленок чаще всего используют хром, нихром (Ni - 80%, Cr - 20%) и кермет из смеси хрома и моноокись кремния (1:1).
Для обкладок конденсаторов используют алюминий, причем до напыления нижней обкладки приходится напылять тонкий слой CrTi, так как адгезия алюминия непосредственно с подложкой недостаточна. Для диэлектрических слоев наиболее распространен моноокись кремния SiO и моноокись германия GeO. Особое место среди диэлектриков занимают окислы Ta2O5 и Al2O3.
Для проводниковых пленок и омических контактов используют, как правило, либо золото с подслоем CrTi, либо медь с подслоем ванадия. Толщина проводящих пленок 0,5 - 1 мм.
Подложки должны обладать свойствами хорошей изоляции, малой диэлектрической проницаемости, высокой теплопроводности, достаточной механической прочности, полируемости (шероховатость не должна превышать 25 - 50 нм), ТКЛР должен быть близок к ТКЛР используемых пленок. Наиболее распространенные материалы для подложек - ситаллы и керамика.
Похожие статьи
-
Микроэлектроника. Основные понятия. Микроэлектроника - это раздел электроники, охватывающий исследования и разработку качественно нового типа электронных...
-
Микросхема диэлектрический биполярный полупроводниковый Полупроводниковая ИС - это микросхема, которая представляет собой кристалл полупроводника, в...
-
Гибридные интегральные микросхемы - Интегральные микросхемы
Широкое распространение получили гибридные ИС - интегральные схемы, в которых пассивные элементы - пленочные, а активные элементы (резисторы,...
-
Технология изготовления ППИС на БТ. Элементы ППИС необходимо изолировать друг от друга что бы необходимые соединения осуществлялись только путем...
-
Интегральная микросхема - это микроэлектронное изделие, выполняющее определенную функцию преобразования и обработки сигналов и имеющее высокую плотность...
-
Изоляция диэлектриком., Комбинированные способы изоляции. - Основы микроэлектроники
1. EPIC-технология. Исходная пластина n-кремния покрывается эпитаксиальным n+-слоем, толщиной 2-3 мкм. Затем в пластине вытравливают канавки глубиной...
-
Физика полупроводниковых структур - Основы микроэлектроники
В полупроводниках существует два основных механизма переноса носителей заряда: 1) Диффузия - направленное перемещение носителей заряда в кристалле в...
-
Элементы ППИС. - Основы микроэлектроники
1. Разновидность биполярных интегральных транзисторов. 1) Многоэмиттерные транзисторы. МЭТ - составляют основу класса цифровых схем ТТМ. Недостатки: Ш...
-
ПРОГРАММИРУЕМЫЕ ЦИФРОВЫЕ ИНТЕГРАЛЬНЫЕ СХЕМЫ - Цифровые устройства и микропроцессоры
Проектирование современных цифровых устройств невозможно без использования программируемых цифровых ИС (ПЦИС). Они обладают следующими преимуществами...
-
Для преобразования можно использовать как непосредственно аксиомы алгебры логики, так и специальные приемы. Произведем упрощение выражения для F на...
-
Описание гидравлической схемы машины - Технические основы создания машин
Гидросистема (см. СДМ. МС413.15.00.00 ГС) служит для управления рабочим оборудованием и поворотом машины. Гидросистема включает в себя два...
-
Основные параметры логических интегральных микросхем Входное U1вх и выходное U1вых напряжения логической единицы - значение высокого уровня напряжения на...
-
Загальна схема системи зв'язку - Теорія інформації як основа інформаційних технологій
Вона складається з 5 частин: 1. Джерело повідомлень, що створює повідомлення або послідовність повідомлень, які повинні бути передані. Повідомлення...
-
Схемы ЭСЛ _ эмиттерно-связанной логики - Электроника и схемотехника аналоговых устройств
Цифровые микросхемы эмиттерно-связанной логики имеют более высокое быстродействие, чем схемы ТТЛ (даже ценой большей рассеиваемой мощности), достигшее в...
-
Упрощенная схема стабилизатора - Интегральный линейный стабилизатор напряжения
В упрощенном виде схема линейного стабилизатора напряжения приведена на рис. 1. Схема состоит из операционного усилителя, включенного по схеме...
-
Проектом предусматривается устройство городской телефонной связи, телефонной оперативной связи и локальной вычислительной сети (ЛВС) стоматологической...
-
Схемы ТТЛ _ транзисторно-транзисторной логики - Электроника и схемотехника аналоговых устройств
Разновидности схем ТТЛ Также широко используются на практике разновидности схем ТТЛ: А) схема ТТЛ с тремя состояниями выхода Схемы базовых ТТЛ нельзя...
-
Разработка функциональной схемы устройства - Разработка автомобильной охранной сигнализации
Функциональная схема автомобильной сигнализации показана на рисунке 6. Функциональная схема брелока управляющего автомобильной сигнализацией показана на...
-
Схема ДТЛ - диодно-транзисторной логики - Электроника и схемотехника аналоговых устройств
Основная схема ДТЛ приведена на рисунке 2.16,а. Здесь диоды VD1, VD2, VD3 и резистор R1 представляют собой конъюнктор (И), элементы VT, R2, R3 _ инвертор...
-
Разработка функциональной схемы опорного пункта (ОП) Оборудование выполнено в виде стоек, устанавливаемых в пунктах волоконно-оптической линии передачи:...
-
Выбор конструктивно-силовой схемы агрегата Представляется несколько вариантов регулярной конструктивно-силовой схемы (КСС) агрегата: нервюрно-стрингерный...
-
Структурная схема разрабатываемого устройства представлена на рисунке 3.1. Рисунок 3.1. Структурная схема устройства. 1 - Входной буферный каскад 2 -...
-
Эффективное кодирование - Основы построения телекоммуникационных систем и сетей
Эффективное кодирование - это процедуры направленные на устранение избыточности. Основная задача эффективного кодирования: обеспечить, в среднем,...
-
Модуль памяти первого процессора включает в себя оперативное запоминающее устройство выполненное на двух микросхемах динамического типа с организацией...
-
Основы работы катка - Совершенствование энергетической установки дорожного катка
При установившемся движении материал (рисунок 2)в зоне его контакта с ведомым вальцом катка действует вертикальная сила, равная вертикальной нагрузке, и...
-
Оборонительные системы, Связная инфраструктура - Интегральные системы безопасности
Для предотвращения развития вторжения на охраняемую территорию используется оборонительная система, в которой находят применение осветительные или...
-
После проведения анализа доступной элементной базы, было принято решение использовать отечественные микросхемы серий К155, К555 и КР1533 со следующими...
-
Расчет схемы электрической принципиальной цифрового матрицирующего устройства. Рассмотрим систему обозначений сигналов, принятую в цифровом телевидении...
-
Двигатель, топливо и ходовая часть. - Гибридные экскаваторы
Модель 336E H оснащается двигателем Cat C9.3 ACERT, предназначенным для работы на дизельном топливе с очень низким содержанием серы или на смеси...
-
Выбор структурной схемы разрабатываемого устройства - Связной передатчик с угловой модуляцией
Структурные схемы передатчиков с УМ, а именно с фазовой, весьма разнообразны. Они различаются числом каскадов, уровнем проведения модуляции, структурными...
-
Для производства Многослойных печатных плат используются различные стеклотекстолиты по условию технического задания устройство должно работать в условиях...
-
Корпорация "Авиационное радио" (англ. Aeronautical Radio, Incorporated, ARINC) -- компания, основанная в 1929 году, один из мировых лидеров в разработке...
-
Цель: вычислить потребляемую мощность схемы программатора. Данные по элементам и рассчитанная мощность сведены в таблицу 2. Таблица 2 - Потребляемая...
-
Допущения, принятые при расчетах в базах данных G1000 Траектория и конечный пункт рассчитываются исходя из следующих условий: - Скорость - путевая...
-
Подготовка к полету 1) При подготовке к полету необходимо убедиться в том, что навигационная инфраструктура на время предполагаемого полета обеспечит...
-
В легко доступном для экипажа месте должен находиться документ "Комплекс Garmin G1000. Справочное руководство", номер 190-00384-08 (в соответствующей...
-
Характеристики комплекса G1000 Комплекс G1000 представляет собой комплексную полнофункциональную систему, выполняющую пилотажные функции, функции...
-
Осуществление навигации невозможно без применения систем координат. При использовании СНС для целей аэронавигации используется геоцентрическая система...
-
Подход - Основы зональной навигации и ее применение в пилотажно-навигационном комплексе Garmin 1000
1) Еще до начала выполнения маневра подхода экипаж должен убедиться в том, что нужная процедура загружена (в систему RNAV). Активный план полета должен...
-
Общая схема модельного эксперимента Проведенный в рамках диссертации модельный эксперимент ставил задачей определение эффективности работы сети с...
Гибридные интегральные схемы - Основы микроэлектроники