Изоляция диэлектриком., Комбинированные способы изоляции. - Основы микроэлектроники
1. EPIC-технология.
Исходная пластина n-кремния покрывается эпитаксиальным n+-слоем, толщиной 2-3 мкм. Затем в пластине вытравливают канавки глубиной 10-15 мкм. Всю поверхность окисляют и напыляют слой поликристаллического кремния (200-300 мкм). Структуру переворачивают и сошлифовывают вплоть до канавок. В результате получаются n-карманы со срытым n+-слоем, в которых формируют элементы полупроводниковых ИС.
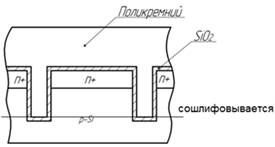
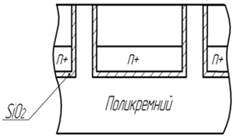
2. КНС-технология (кремний на сапфире).
Изготовление больших интегральных схем (БИС) на основе структур "кремний на сапфире" (КНС) имеет ряд преимуществ по сравнению с изготовлением их на подложке кремния, таких как быстродействие, снижение расхода мощности, высокая плотность упаковки элементов. Перед наращиванием слоя кремния в камере роста проводился отжиг подложки при температуре T = 1400°C в течение 30 минут.
После снижения температуры подложки до заданной (500-850°C) проводится осаждение слоя кремния со скоростью ~ 1 мкм/час. Затем этот слой протравливается до подложки и образуются островки-карманы, в которых формируются элементы.
Комбинированные способы изоляции.
1. Изопланарная технология.
В основе метода лежит локальное прокисление эпитаксиального слоя n-Si через маску нитрида кремния SiN4. В результате эпитаксиальный слой оказывается разделенным на отдельные карманы. Боковые изолирующие слои диэлектрические, а донные части карманов изолированы встречно включенными p-n-переходами.

Замечания:
- - Боковые изолированные слои не полупроводниковые, а изолирующие т. к. окисление идет на всю глубину эпитаксиального слоя (не более 1 мкм). - Донные же части карманов разделены p - n - переходами, поэтому метод относится к комбинированным. - Каждый карман в свою очередь разделен окислом на две части. В главной части осуществляется база и эмиттер во второй - коллектор. Обе части связаны через скрытый n+ слой, что уменьшает коллекторную емкость. - Локальное прокисление эпитаксиального слоя создается по всей его толщине, при этом толщина эпитаксиального слоя не превышает 1 мкм. Получение пленки SiO a при термическом окислении толщиной более 1 мкм очень длительный процесс. - Этот метод обеспечивает высокую плотность компоновки элементов, применяется для изготовления изоляции БИС. 2. Метод изоляции V-канавками.
В основе метода лежит сквозное протравливание эпитаксиального n-слоя методом анизотропного травления, при этом поверхность должна иметь ориентацию 1.0.0, травление идет по плоскостям 1.1.1. Грани этих плоскостей сходятся чуть ниже границы эпитаксиального слоя. Рельеф окисляется затем на всю поверхность напыляется поликристаллический кремний для выравнивания.
Похожие статьи
-
Микросхема диэлектрический биполярный полупроводниковый Полупроводниковая ИС - это микросхема, которая представляет собой кристалл полупроводника, в...
-
Технология изготовления ППИС на БТ. Элементы ППИС необходимо изолировать друг от друга что бы необходимые соединения осуществлялись только путем...
-
Физика полупроводниковых структур - Основы микроэлектроники
В полупроводниках существует два основных механизма переноса носителей заряда: 1) Диффузия - направленное перемещение носителей заряда в кристалле в...
-
Гибридные интегральные схемы - Основы микроэлектроники
Гибридная ИС (ГИС) - микросхема которая представляет собой комбинацию пленочных пассивных элементов и активных компонентов расположенных на общей...
-
Нанесение защитной пленки диэлектрика (Si02) - Электроника и схемотехника аналоговых устройств
После формирования кремниевой подложки наступает этап создания сложнейшей полупроводниковой структуры. Для этого в кремний нужно внедрить так называемые...
-
Элементы ППИС. - Основы микроэлектроники
1. Разновидность биполярных интегральных транзисторов. 1) Многоэмиттерные транзисторы. МЭТ - составляют основу класса цифровых схем ТТМ. Недостатки: Ш...
-
Микроэлектроника. Основные понятия. Микроэлектроника - это раздел электроники, охватывающий исследования и разработку качественно нового типа электронных...
-
Передача информации при комбинированном методе - Конструкция самолетов
Самолетостроение конструктивный плаз геометрический По мере развития программно-технических средств и опыта использования современных компьютерных...
-
Способ технической реализации - Основы проектирования приборов и систем
Выходные величины проектируемого ИПАМ, напряжение и ток, содержат помехи в виде как свободных апериодической и колебательных составляющих, так и...
-
Классификация основных способов и методов (обеззараживания) воды приведена на Рисунке 1. Рисунок 1 Классификация основных способов и методов...
-
Железнодорожный транспорт на сегодняшний день является самым безопасным и надежным видом транспорта. Безопасность на железнодорожном транспорте...
-
Изготовление слоя технологических перемычек Напыление слоя Cr-Cu Включить вакуумную установку в соответствии с инструкцией по ее эксплуатации....
-
После формирования кремниевой подложки наступает этап создания сложнейшей полупроводниковой структуры. Для этого в кремний нужно внедрить так называемые...
-
Теоретические основы Сигнал, поступающий с выхода канала постоянного тока (КПТ), должен быть отождествлен на приемной стороне с "0" или "1". Необходимо...
-
Эффективное кодирование - Основы построения телекоммуникационных систем и сетей
Эффективное кодирование - это процедуры направленные на устранение избыточности. Основная задача эффективного кодирования: обеспечить, в среднем,...
-
Методы регистрации, Теоретические основы - Основы построения телекоммуникационных систем и сетей
Теоретические основы Сигнал, поступающий с выхода канала постоянного тока (КПТ), должен быть отождествлен на приемной стороне с "0" или "1". Необходимо...
-
Таблица 2.1 Наименование неисправности Основные причины возникновения Способы устранения неисправностей 1. Сварочные ожоги - термомеханическое...
-
Рис. 4. Трехслойная печатная плата Многослойные печатные платы имеют ряд достоинств: - В многослойных печатных платах формируется практически полностью...
-
Два варианта такого устройства, соответствующие горизонтальному либо вертикальному расположению отрезка НВЛ в устройстве, показаны на рис. 2.24,а, б . С...
-
Существует несколько технологий восстановления чугунных коленчатых валов[3]. Одним из часто применяемых способов восстановления работоспособности...
-
Для большинства измерений, выполняемых в системах управления технологическими процессами, оценивание погрешности измерений и ее составляющих производится...
-
Скоропортящиеся грузы во всех направлениях перевозятся в основном с большой скоростью. Способы перевозки дифференцируются по периодам года (летний,...
-
Введение - Основы рациональной загрузки портовых складов
Цель курсового проекта - изучение транспортных характеристик грузов, закрепление знаний, полученных при изучении раздела "Основы рациональной загрузки...
-
1. Шаг коррекции (Дц) - смещение фазы ТИ в долях единичного интервала (ф0) на выходе делителя частоты (ДЧ) при добавлении или вычитании одного...
-
ГОСТ Р МЭК 536-94 определяет классы оборудования. Разделение на классы защиты отражает не уровень безопасности оборудования, а лишь указывает на то,...
-
Краткие сведения по основам законодательства о труде, производственной санитарии, технике безопасности, пожарной профилактике Охрана труда - это система...
-
Алгоритм STP требует, чтобы каждому коммутатору был присвоен идентификатор. Идентификатор коммутатора - 8-байтное поле, которое состоит из 2-х частей:...
-
Наиболее распространенным является создание резервных связей между коммутаторами на основе двух технологий: 1. Режим резервирования, когда одно из...
-
В качестве основного параметра, характеризующего канал связи, используется вероятность ошибки р в зависимости от отношения h средних мощностей сигнала Wс...
-
Проблема пробок остро стоит во многих странах мира, а попытки ее разрешить многочисленны и разнообразны. Во многих странах Европы и в Японии созданы...
-
Актуальність теми Актуальність даної курсової роботи полягає в тому, що останні роки в Фото електроніці досягнуто ряд істотних успіхів. Досить важливу...
-
Основы работы катка - Совершенствование энергетической установки дорожного катка
При установившемся движении материал (рисунок 2)в зоне его контакта с ведомым вальцом катка действует вертикальная сила, равная вертикальной нагрузке, и...
-
Стратегия ремонта это? А) Это система правил однозначно определяющих выбор решения о содержании, места и времени выполнения ремонтных работ, о списании...
-
Классификация систем синхронизации Синхронизация есть процесс установления и поддержания определенных временных соотношений между двумя и более...
-
При регистрации методом стробирования посылка регистрируется в середине, то допускается смещение любого значащего момента на величину 0,5ф 0 =м , где М -...
-
Промислові мережі - інтегровані, відкриті промислові комунікації. Промисловий Ethernet (IEEE 802. 3) міжнародний стандарт для мереж що мають як...
-
Визначення структури і складу системи керування робиться за допомогою конфігуратора HW Config , який є складовою частиною язика програмування. Він...
-
Постановка задачи при структурном проектировании выглядит следующим образом: требуется назначить функции отдельных слоев в МПП таким образом, чтобы все...
-
Первичные сигналы электросвязи и их характеристики. - Основы техники связи
Электрический сигнал, получаемый на выходе преобразователя сообщения (см. рисунок 2.1, глава 2), называется первичным сигналом электросвязи. Параметр...
-
ПОДГОТОВКА ГРУЗОВЫХ ПОМЕЩЕНИЙ - Основы управление флотом и технология перевозки грузов
Должна производиться в соответствии с требованиями РТМ 31.2003. Подготовка судна к приему груза должна включать: Приведение трюмов в соответствие для...
Изоляция диэлектриком., Комбинированные способы изоляции. - Основы микроэлектроники