Элементы полупроводниковых ИМС на биполярных транзисторах
Элементы полупроводниковых ИМС на биполярных транзисторах
Транзисторы типа п-р-п. Биполярный транзистор типа п-р-п является основным схемным элементом полупроводниковых ИС. Он обладает лучшими характеристиками, чем транзистор типа р-п-р, а технология его изготовления более проста. Остальные элементы ИМС выбирают и конструируют таким образом, чтобы они совмещались со структурой транзистора типа п-р-п. Их изготовляют одновременно с транзистором типа п-р-п на основе какой-либо из его областей. Таким образом, выбор физической структуры транзистора типа п-р-п определяет основные электрические параметры остальных элементов микросхемы.
Наиболее широкое распространение получила транзисторная структура типа п+-р-п со скрытым подколлекторным n+-слоем (рис. 1).
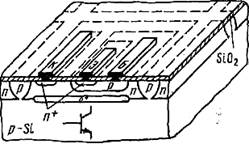
Рис.1. Конструкция интегрального транзистора n+-p-n типа
Следует обратить внимание на то, что вывод коллектора интегрального транзистора расположен на поверхности прибора. Это увеличивает сопротивление тела коллектора и ухудшает характеристики транзистора в усилительном режиме (ухудшается частотная характеристика) и в переключающем режиме (уменьшается эффективность переключения в режиме насыщения). Увеличение степени легирования всего объема коллекторной области и уменьшение ее удельного сопротивления снижают пробивное напряжение перехода коллектор - база и увеличивают емкость этого перехода, т. е. также ухудшают характеристики транзистора. Компромиссным решением проблемы является создание скрытого высоколегированного n+-слоя на границе коллектора и подложки.

Этот слой обеспечивает низкоомный путь току от активной коллекторной зоны к коллекторному контакту без снижения пробивного напряжения перехода коллектор - база. Конструктивно он располагается непосредственно под всей базовой областью и простирается вплоть до дальней от базы стороны коллекторного контакта. Толщина слоя составляет 2,5-10 мкм, удельное поверхностное сопротивление. Рабочая зона транзистора начинается непосредственно под эмиттерной зоной, и для обеспечения требуемого коллекторного тока при минимальном последовательном падении напряжения коллекторный контакт располагают как можно ближе к эмиттерному. Минимальные горизонтальные размеры прибора определяются двумя основными технологическими факторами: минимально достижимыми при фотолитографии размерами окон в окисле кремния и зазоров между окнами, а также размером боковой диффузии под окисел. Поэтому при проектировании транзистора следует учитывать, что расстояние между базовой областью и коллекторным контактом должно быть значительно больше суммы размеров боковой диффузии р-базы и n+-области под коллекторным контактом. Назначение этой n+-области состоит в обеспечении надежного формирования невыпрямляющего контакта алюминия к слаболегированной n-области коллектора, поскольку алюминий является акцепторной примесью в кремнии с растворимостью порядка 1018 атомов/см3 при температуре формирования контакта. Уровень же легирования эпитаксиального n-слоя, составляющего тело коллектора, равен 1015-1016 атомов/см3.
Как отмечалось, он диктуется необходимостью увеличения напряжения пробоя перехода коллектор - база.
Расстояния между изолирующей р-областью и элементами транзистора определяются также размером боковой диффузии. Они должны быть примерно равны толщине эпитаксиального слоя.
Две типичные конструкции интегральных транзисторов показаны на рис. 2. Для асимметричной конструкции (рис. 1, 2, а) характерно то, что коллекторный ток протекает к эмиттеру только в одном направлении. При симметричной конструкции (рис. 2, б) коллекторный ток подходит к эмиттеру с трех сторон и сопротивление коллектора оказывается примерно втрое меньше, чем при асимметричной конструкции. Для симметричной конструкции транзистора облегчается разработка топологии металлической разводки, так как в ней часть коллекторной области можно разместить под окислом, а поверх окисла над коллектором провести алюминиевую полоску к эмиттерной (рис. 2, б) или базовой области. На рис. 2, а даны топологические размеры областей интегрального биполярного транзистора, типичные для ИМС средней степени интеграции. Параметры этих областей приведены в табл. 1.
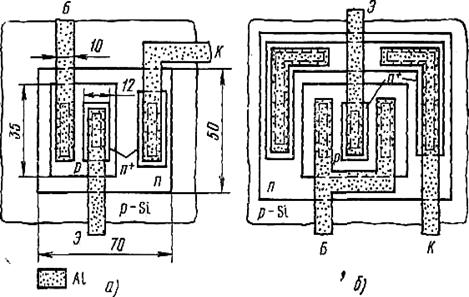
Рис.2. Конструкция биполярных интегральных транзисторов: а - асимметричная; б - симметричная
При больших токах существенную роль играет эффект вытеснения тока эмиттера, который объясняется достаточно просто. Напряжение в любой точке эмиттерного перехода представляет собой разность внешнего напряжения и падения напряжения в объеме базы, т. е. напряжение в центральной части эмиттера меньше напряжения у его краев, и внешние области эмиттера работают при больших плотностях тока по сравнению с внутренними.
Таблица 1
Параметры областей интегрального транзистора типа п-р-п
|
Наименование области |
Концентрация примеси N, см-3 |
Толщина слоя d, мкм |
Удельное объемное сопротивление материала с, Ом-см |
Удельное поверхностное сопротивление слоя с5, Oм/м2 |
|
Подложка р-типа |
1,5-1015 |
200-400 |
10 |
- |
|
Скрытый n+-слой |
- |
2,5-10 |
- |
10-30 |
|
Коллекторная n-область |
1O16 |
2,5-10 |
0,15-5,0 |
- |
|
Базовая р-область |
5-1018 |
1,5-2,5 |
- |
100-300 |
|
Эмиттерная n+-область |
1021 |
0,5-2,0 |
- |
2-15 |
|
Изолирующая область |
- |
3,5-12 |
- |
6-10 |
|
Пленка окисла кремния |
- |
0,3-0,6 |
- |
- |
|
Металлическая пленка (алюминий) |
- |
0,6-1,0 |
1.7 -10-6 |
0,06-0,1 |
Повышенная плотность тока у краев эмиттера приводит к повышенным рекомбинационным потерям носителей заряда в этих областях и к уменьшению коэффициента усиления транзистора В. Конструкция мощных транзисторов должна обеспечивать максимальное отношение периметра эмиттера к его площади. Например, целесообразно использовать узкие эмиттеры с большим периметром (рис. 3).
Параметры интегральных транзисторов типа п-р-п приведены в табл. 2.
Рассмотрим разновидности интегральных биполярных транзисторов.
Транзисторы с тонкой базой. Транзисторы с тонкой базой обладают повышенными значениями коэффициента усиления по току В и необходимы для создания ряда аналоговых ИМС (входные каскады операционных усилителей). У этих транзисторов ширина базы (расстояние между эмиттерным и коллекторным переходами) w = 0,2-0,3 мкм, коэффициент усиления B = 2000-5000 при коллекторном токе IК = 20 мкА и уровне напряжения коллектор-эмиттер UКэ=0,5 В. Пробивное напряжение коллектор-эмиттер около 1,5-2 В.
Таблица 2
Параметры интегральных транзисторов типа п-р-п
|
Параметры |
Номиал |
Допуск, % |
|
Коэффициент усиления В Предельная частота fТ, МГц Пробивное напряжение Uкб, В Пробивное напряжение UЭб, В |
|
±30 ±20 ±30 ±5 |
Многоэмиттерные транзисторы (МЭТ). Конструкция МЭТ, широко используемых в цифровых ИМС транзисторно-транзисторной логики, приведена на рис. 4. Число эмиттеров может быть равным 5-8. МЭТ можно рассматривать как совокупность транзисторов с общими базами и коллекторами. При их конструировании необходимо учитывать следующие обстоятельства.

1 - эмиттерная область; 2 - область базы; 3 - область изоляции; 4 - коллекторная область
Рис.3. Конструкция мощного транзистора (вид сверху)
Для подавления действия паразитных горизонтальных п+-р-п+-транзисторов расстояние между краями соседних эмиттеров должно превышать диффузионную длину носителей заряда в базовом слое. Если структура легирована золотом, то диффузионная длина не превышает 2-3 мкм и указанное расстояние достаточно сделать равным 10-15 мкм.

Рис.4. Конструкция многоэмиттерного транзистора
Для уменьшения паразитных токов через эмиттеры при инверсном включении МЭТ искусственно увеличивают сопротивление пассивной области базы, удаляя базовый контакт от активной области транзистора, чтобы сопротивление перешейка, соединяющего базовый контакт с базовой областью, составило 200-300 Ом.
Транзисторы типа p-n-p. Интегральные транзисторы типа p-n-p существенно уступают транзисторам типа n-p-n по коэффициенту усиления и предельной частоте. Для их изготовления используют стандартную технологию, оптимизированную для формирования транзистора типа n+-p-n. Естественно, что получение транзисторов типа p-n-p с близкими к теоретическим пределам параметрами в этом случае невозможно.
Горизонтальные транзисторы типа р-п-р. В настоящее время эти транзисторы используют в ИМС наиболее часто. Их изготовляют одновременно с транзисторами типа п+-р-п по обычной технологии. Эмиттерный и коллекторный слои получают на этапе базовой диффузии, причем коллекторный слой охватывает эмиттер со всех сторон. Базовая область формируется на основе эпитаксиального слоя с подлегированием контактной области во время эмиттерной диффузии. Перенос носителей заряда в транзисторе типа р-п-р происходит в горизонтальном направлении. Дырки, инжектированные из боковых частей эмиттера в базу, диффундируют к коллекторной области. Перенос наиболее эффективен в приповерхностной области, так как здесь расстояние w между коллектором и эмиттером минимально и, кроме того, наиболее высокая концентрация примеси в р-слоях. Ширину базы w удается выполнить равной 3-4 мкм (мешает боковая диффузия под маску), в результате чего коэффициент усиления оказывается равным 50, а fT ==20-40 МГц. Для подавления действия паразитных р-n-р-транзисторов (р-эмиттер, п-эпитаксиальный слой, р - подложка) стремятся уменьшить площадь донной части эмиттера (его делают возможно более узким), используют скрытый п+-слой вдоль границы эпитаксиального слоя и подложки.
Основные недостатки горизонтального транзистора типа р-п-р - сравнительно большая ширина базы и однородность распределения примесей в ней (транзистор является бездрейфовым).
Составные транзисторы. Составные интегральные транзисторы могут быть реализованы на основе двух транзисторов одного или разных типов, расположенных в одной изолированной области.
Составной транзистор имеет коэффициент усиления, равный произведению коэффициентов усиления составляющих его транзисторов: В?В1В2, однако быстродействие составного транзистора определяется наименее быстродействующим транзистором.
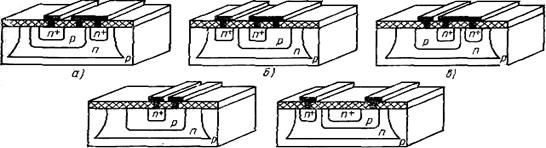
г) д)
Рис.5. Конструкции интегральных диодов
Интегральные диоды. Любой из р-п-переходов планарно-эпитаксиальной структуры может быть использован для формирования диодов, но только переходы база - эмиттер и база - коллектор действительно удобны для схемных применений.
Пять возможных вариантов диодного включения интегрального транзистора показаны на рис. 5: а - переход база - эмиттер с коллектором, закороченным на базу; б - переход коллектор - база с эмиттером, закороченным на базу; в - параллельное включение обоих переходов; г - переход база-эмиттер с разомкнутой цепью коллектора; д-интегральных диодов приведены в табл. 3.
Таблица 3
Параметры интегральных диодов
|
Вариант включения |
Значение параметров | ||||
|
Пробивное напряжение UПр, В |
Обратный ток IОбр, нА |
Емкость диода СД, пФ |
Паразитная емкость на подложку СО, пФ |
Время восстановления обратного тока tВ, нс | |
|
БК-Э БЭ-К Б-ЭК Б-Э Б-К |
|
|
|
|
|
Из анализа таблицы видно, что варианты включения различаются по электрическим параметрам. Пробивные напряжения UПр , больше для вариантов с коллекторным переходом, обратные токи IОбр - для вариантов только с эмиттерным переходом, имеющим наименьшую площадь. Емкость диода между катодом и анодом СД Для варианта с наибольшей площадью переходов максимальна (Б-ЭК). Паразитная емкость на подложку СО (считается, что подложка заземлена) минимальна для варианта Б-Э. Время восстановления обратного тока tВ, характеризующее время переключения диода из открытого состояния в закрытое, оптимально для варианта БК-Э, так как здесь заряд накапливается только в базе.
Оптимальными для ИМС вариантами включения являются БК-Э и Б-Э, причем чаще используется БК-Э. Пробивные напряжения (7-8 В) достаточны для использования этих вариантов в низковольтных ИМС.
Интегральные резисторы. Резисторы ИМС формируют в любом из диффузионных слоев транзисторной структуры (эмиттерная и базовая области), в эпитаксиальном слое (коллекторная область) и с помощью ионного легирования.
Рассмотрим разновидности интегральных резисторов.
Диффузионные резисторы. Диффузионные резисторы (ДР) изготовляют одновременно с базовой или эмиттерной областью (рис. 6-8.) Сопротивление ДР представляет собой объемное сопротивление участка диффузионного слоя, ограниченного р-п-переходом. Оно определяется геометрическими размерами резистивной области и распределением примеси по глубине диффузионного слоя, которое, в свою очередь, характеризуется удельным поверхностным сопротивлением сS. Значение сS является конструктивным параметром резистора, зависящим от технологических факторов (режима диффузии). При создании ИМС параметры диффузионных слоев оптимизируют с целью получения наилучших характеристик транзисторов типа п-р-п, поэтому параметры ДР улучшают не варьированием технологических режимов, а выбором конфигурации и геометрических размеров резистора.

Рис.6. Конструкция диффузионного резистора на основе базовой области
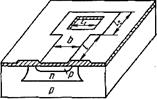
Рис.7. Поперечный разрез структуры диффузионного резистора на основе базовой области

Рис.8. Конструкция диффузионного резистора на основе эмиттерной области
Конфигурации диффузионных резисторов даны на рис. 9. Низкоомные (десятки Ом) резисторы (рис. 9 а) имеют малое отношение l/b. Форму и размеры контактов к ним выбирают такими, чтобы сопротивление приконтактных областей было значительно меньше сопротивления основной области резистора. Резисторы с сопротивлением от сотен Ом до единиц килоОм в плане имеют вид, изображенный на рис. 9 б, в. Здесь длина и ширина приконтактной области равны ширине резистора. Топологию, показанную на рис. 9 г, д, используют для создания высокоомных резисторов (до 20 кОм).Эти резисторы имеют сравнительно малую ширину, размеры приконтактных областей определяются возможностями технологии создания надежного контакта проводящих алюминиевых полосок с полупроводниковым материалом. Еще более высокоомные резисторы (до 60 кОм) имеют форму меандра (рис. 9 е) или изготовляются в донной части базовой области (пинч-резисторы, рис. 9 ж). Длина однополоскового диффузионного резистора не может превышать размеров активной области кристалла (1-5 мм), ширина ограничена минимальной шириной окна под диффузию, определяемой возможностями фотолитографии (2,5-3 мкм), и боковой диффузией (уход примеси под окисел равен примерно глубине диффузионного р-п-перехода). Типичные значения сопротивления диффузионных резисторов, которые можно получить при данном значении сS, лежат в диапазоне 4сS <R<104 сS. Нижний предел ограничивается сопротивлениями приконтактных областей, верхний - допустимой площадью, отводимой под резистор.

Рис.9. Конфигурация диффузионных резисторов
Максимальное сопротивление ДР на основе базовой области приблизительно равно 60 кОм, если площадь, отведенная под резистор, не очень велика (не более 15% от площади кристалла). Воспроизводимость номинальных значений сопротивления обычно составляет 15- 20% и зависит от ширины резистора (табл. 4).
Отклонения от номиналов сопротивлений резисторов, расположенных на одном кристалле, за счет неточностей технологии имеют один и тот же знак, поэтому отношение сопротивлений сохраняется с высокой точностью (табл.4). Аналогично, температурный коэффициент отношения сопротивлений мал по сравнению с ТКR для отдельного резистора [(1,5-3)-10-4 1/°С]. Эту особенность диффузионных резисторов учитывают при разработке полупроводниковых ИМС.
Таблица 4
Точность изготовления диффузионных резисторов на основе базовой области и отношения их сопротивлений
|
Ширина резистора, мкм |
Точность воспроизведения номинала Сопротивления, % |
Точность отношения Сопротивлений, % | |
|
1:1 |
1:5 | ||
|
±15 ±8 |
±2 ±0,5 |
±5 ±1,5 |
На основе эмиттерной области формируются резисторы небольших номиналов [3-100 Ом с ТКR= (1ч2)-10-4 1/°С], поскольку значение сS эмиттерного слоя невелико (см. табл. 1).
Пинч-резисторы. При необходимости создания в ИМС резисторов с сопротивлением более 60 кОм используют пинч-резисторы (синонимы: канальные, сжатые, закрытые резисторы). Их формируют на основе донной, слаболегированной базовой области, имеющей большее сопротивление и меньшую площадь сечения (рис. 10-11).
 
Рис.10. Конструкция пинч-резистора |
Максимальное сопротивление таких резисторов составляет 200-300 кОм при простейшей полосковой конфигурации, сS = 2ч5 кОм/м2. Пинч-резисторы имеют большой разброс номиналов (до 50%) из-за трудностей получения точных значений толщины донной части р-слоя, большого ТКR= (3ч5)-10-3 1/°С вследствие меньшей степени легирования донной части.

Рис.11. Конструкция пинч-резисторов на основе базовой области с использованием эмиттерной диффузии (закрытый I и полузакрытый II варианты)
У пинч-резистора п+- и р-слои закорочены металлизацией и соединены с выводом резистора, находящимся под большим положительным потенциалом, чем остальные области структуры.
Такое соединение обеспечивает обратное смещение на всех переходах пинч-резистора. Этот резистор имеет линейный участок в. а. х. только до напряжений 1-1,5 В, его пробивное напряжение равно 5-7 В (эмиттерный переход, см. табл. 2).
Эпитаксиальные резисторы. Из трех областей транзистора коллекторная имеет наименьшую концентрацию легирующей примеси и максимальное значение сS (500-5000 Ом/кв). Поскольку эпитаксиальный слой легирован однородно, проводимость эпитаксиального резистора (ЭР) постоянна по всему его сечению в отличие от ДР. У ЭР (рис. 12) поперечное сечение по форме существенно отличается от сечений ДР, ибо эпитаксиальный резистор формируется разделительной диффузией. Так как эта диффузия самая продолжительная и точная регулировка размеров диффузионных областей, особенно величины боковой диффузии, затруднена, разброс номиналов сопротивления ЭР значителен. Казалось бы, что большие значения сS позволяют экономить площадь кристалла при формировании ЭР больших номиналов, однако значительная площадь области разделительной диффузии (рис.12) сводит на нет это преимущество. Эпитаксиальные резисторы имеют высокое напряжение пробоя (>100 В) и большой TKR, поскольку коллекторная область легирована слабо.

Рис.12. Конструкция интегрального резистора на основе коллекторной области
Эпитаксиальные пинч-резисторы. Конструкции, этих резисторов отличаются от обычного ЭР тем, что их поперечное сечение уменьшено сверху на глубину базового слоя, что и предопределяет большие, чем у ЭР, значения сS (сS = 4-8 кОм/кв) и номиналы сопротивления при одной и той же площади (рис.13).
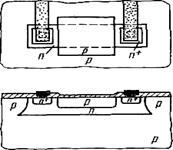
Рис. 13. Конструкция эпитаксиального пинч-резистора
Пробивное напряжение этих резисторов определяется пробивным напряжением UКб (см. табл. 3.2), ТКR=4-10-3 1/°С.
Ионно-легированные резисторы. Структура этих резисторов такая же, как и у ДР, но глубина ионно-легированных слоев, в которых сформировано тело резистора, составляет лишь 0,1-0,3 мкм (рис. 14). Ионная имплантация может обеспечить малую концентрацию легирующей примеси в слое. При соответствующем выборе дозы легирования и параметров отжига (10-20 мин при 500-600°С) можно получить сS=0,5-20 кОм/кв в резисторах со структурой рис. 14, а и сS=500-1000 Ом/кв в резисторах со структурой рис.14, б

Рис.14. Конструкции ИЛР, сформированных имплантацией примеси р-типа в эпитаксиальный (коллекторный) слой (а) и примеси n-типа в базовый слой (б)
Могут быть достигнуты номиналы сопротивлении в сотни килоОм со сравнительно низким TKR и допуском ±10%. Ширина и толщина ионно-легированных резисторов с большими номиналами сопротивлений очень малы, что усложняет получение качественного омического контакта. Для формирования надежных контактов используют диффузионные р - или п-области, которые создают на стадии базовой или эмиттерной диффузии (рис. 14).
Характеристики интегральных резисторов. Типичные характеристики интегральных резисторов приведены в табл. 5. Интегральные конденсаторы. В интегральных полупроводниковых конденсаторах роль диэлектрика могут выполнять обедненные слои обратно смещенных р-п-переходов или пленка окисла кремния, роль обкладок - легированные полупроводниковые области или напыленные металлические пленки. Характеристики конденсаторов полупроводниковых ИМС невысоки; кроме того, для получения сравнительно больших емкостей необходима значительная площадь схемы. Поэтому при проектировании электрической схемы полупроводниковой ИМС стремятся избегать применения конденсаторов.
Таблица 5
Характеристики интегральных резисторов
|
Тип резистора |
Толщина слоя, мкм |
Поверхностное сопротивление сS, Ом/м2 |
Допуск, % |
ТКR(бR), 1/°С |
Паразитная емкость, пФ/мм2 |
|
Диффузионный резистор на основе базовой области Пинч-резистор Диффузионный резистор на основе эмиттерной области |
|
|
±(5-20) ±50 ±20 |
±(0,5-3)-10-3 ±(1,5-3)-10-3 ±(1-5)-10-4 |
|
|
Эпитаксиальный резистор Ионно-легированный резистор n-типа |
|
|
±(15-25) ±50 |
±(2-4)-10-3 ±(1,5-5)-10-3 |
|
Диффузионные конденсаторы. В ИМС для формирования диффузионных конденсаторов (ДК) может быть использован любой из р-п-переходов (рис. 15): коллектор - подложка (C1), база - коллектор (С2), эмиттер - база (С3), переход р-области изолирующей диффузии и скрытого п+-слоя (С4). Варианты С1 и С4 не могут быть реализованы в ИМС с диэлектрической изоляцией.
В близкой к реальной полупроводниковой структуре (рис. 15) с удельным сопротивлением подложки 10 Ом-см, сопротивлением слоя базы 200 Ом/кв и сопротивлением слоя эмиттера 2 Ом/кв при глубинах p-n-переходов эмиттер - база 2, 3 мкм, база - коллектор 2,7 мкм и коллектор - подложка 12,5 мкм p-n-переходы, используемые для формирования ДК, имеют такие характеристики:
- - удельную емкость дна р-n-перехода коллектор - подложка 100 пФ/мм2, а боковой стенки 250 пФ/мм2; пробивное напряжение перехода до 100 В; - удельную емкость p-n-перехода база - коллектор 350 пФ/мм2, а его пробивное напряжение 30-70 В; - удельную емкость дна р-п-перехода эмиттер - база 600 пФ/мм2, а боковой стенки 1000 пФ/мм2, пробивное напряжение перехода 7 В.

Рис.15. Варианты формирования интегральных диффузионных конденсаторов на основе р-n-переходов
Самую большую удельную емкость (более 1000 пФ/мм2) имеет р-п-переход, область изолирующей р-диффузии - подколлекторный п+-слой, его пробивное напряжение 10 В. ТКС конденсаторов на этом переходе сравнительно большой (2-10-4 1/°С).
Поскольку ширина обедненного слоя обратно смещенного перехода зависит от напряжения, емкость ДК также изменяется с изменением напряжения. Удельную емкость любого полупроводникового перехода можно аппроксимировать формулой C0?K(1/U)M, где К - коэффициент пропорциональности, зависящий от уровня легирования полупроводниковых областей; т - показатель: m= (1/3; Ѕ), причем т=1/2 соответствует ступенчатому, а m=1/3 - линейному переходу. Остальные значения т, входящие в указанное множество, соответствуют реальным распределениям примеси, в том числе гауссову и по функции ошибок.
В табл. 6 даны значения удельной емкости переходов интегрального транзистора со скрытым слоем и без него, с подложкой р-типа (р = 5 Ом-см), гауссовым распределением примеси в базе (ширина 0,7 мкм) и распределением примеси по функции ошибок в эмиттере.
Таблица 6
Значения удельной емкости интегрального транзистора
|
U, В |
СЭб, пФ/мм2 |
СБк, пФ/мм2 |
СКп(с n+-слоем), пФ/мм2 |
СКп(без n+-слоя), пФ/мм2 |
|
|
|
|
|
Эмиттерный переход обладает наибольшей удельной емкостью, но малыми напряжением пробоя и добротностью. Базовый переход используется для формирования ДК наиболее часто. Пример конструкции такого конденсатора приведен на рис.16. Параметры диффузионных конденсаторов на этих переходах приведены в табл. 6.
Значения максимальной емкости даны ориентировочно в предположении, что площадь всех конденсаторов ИМС не превышает 20-25% площади кристалла. Недостатком ДК является необходимость обеспечения строго определенной полярности (см. рис.15), так как условием их нормальной работы является обратное смещение р-n-перехода.

1 - алюминиевый вывод от верхней обкладки конденсатора; 2 - алюминиевый вывод от нижней обкладки конденсатора; 3-пленка золота (контакт к подложке); 4- подложка р-типа; 5 - коллекторная п-область (нижняя обкладка конденсатора); 6 - базовая р-область (верхняя обкладка конденсатора); 7 - пленка окисла кремния
Рис. 16. Конструкция интегрального диффузионного конденсатора
МДП-конденсаторы. Их конструкция представлена на рис. 3.17. Нижней обкладкой служит эмиттерный п+-слой, верхней - пленка А1, диэлектриком - тонкие слои SiO2 или Si3N4. Пoследний предпочтителен вследствие большей емкости СО (диэлектрическая проницаемость нитрида выше, чем окисла кремния), но SiO2 более доступен.

1 - верхняя обкладка; 2 - алюминиевый вывод от нижней обкладки; 3- подложка р-типа; 4 - коллекторная п-область; 5 - п+-слой (нижняя обкладка конденсатора); 6 - тонкий окисел (диэлектрик конденсатора); 7- толстый окисел
Рис. 17. Конструкция интегрального МДП-конденсатора
Толщина диэлектрика составляет 0,05- 0,12 мкм. Параметры МДП-конденсаторов приведены в табл.7. Недостатком МДП-конденсаторов в составе биполярных ИМС является необходимость введения дополнительной операции создания тонкого диэлектрика и еще одной фотолитографии.
Таблица 7
Параметры интегральных конденсаторов
|
Тип конденсатора |
Удельная емкость СО, пФ/мм |
Макси-мальная емкостьСMax,пФ |
Допуск д, % |
ТКС(бС)* *10-3, 1/°С |
Пробивное напряжение UПр, В |
Доброт-ность |
|
ДК на переходах: Б-К Э-Б К-П МДП с диэлектриком: SiO2 Si3N4 Тонкопленочные с диэлектриком: SiO2 Si3N4 |
|
|
±15ч20 ±20 ±15ч20 ±20 ±20 ±20 ±20 |
±3 2-5 |
|
|
Список литературы
- 1. Ненашев А. П. Конструирование радиоэлектронных средств: Учеб. для радиотехнических спец. вузов. - Мн.: Высшая школа, 2000. 2. Основы конструирования изделий радиоэлектроники: Учеб. пособие / Ж. С. Воробьева, Н. С. Образцов, И. Н. Цырельчук и др. - Мн.: БГУИР, 2001
Похожие статьи
-
На прошлой лекции мы рассмотрели работу одного р-п перехода (диода). Однако известно, что гораздо большее применение имеют полупроводниковые приборы с...
-
Биполярные транзисторы - Электроника и схемотехника аналоговых устройств
Транзисторами называются полупроводниковые приборы, способные усиливать электрическую мощность, имеющие три или более выводов, один или более p-n...
-
Для реализации ПУ выберем транзистор КТ503А, который является кремниевым, эпитаксиально-планарным п-р-п универсальным низкочастотным маломощным....
-
Устройство и принцип действия биполярного транзистора - Полупроводниковые приборы, транзисторы
В отличие от полупроводниковых диодов биполярные транзисторы имеют два электронно - дырочных перехода. Основанием прибора служит пластина полупроводника,...
-
Технология изготовления ППИС на БТ. Элементы ППИС необходимо изолировать друг от друга что бы необходимые соединения осуществлялись только путем...
-
1. Физическая Т-образная эквивалентная схема На рисунке 5.12 приведена физическая Т-образная эквивалентная схема транзистора с общей базой, где:?...
-
Схема транзисторного усилителя низкой частоты Упрощенная схема каскада, выполненного на биполярном транзисторе типа р-n-р, включенного по схеме ОЭ,...
-
Определить пределы изменения амплитуд входного тока и напряжения, выходного тока и напряжения в линейном режиме работы усилителя. Найти: IБm, IКm, UБэm,...
-
Входная и выходная характеристики транзистора с ОЭ несколько отличаются от характеристик транзистора с ОБ. Входной характеристикой транзистора,...
-
Элементы ППИС. - Основы микроэлектроники
1. Разновидность биполярных интегральных транзисторов. 1) Многоэмиттерные транзисторы. МЭТ - составляют основу класса цифровых схем ТТМ. Недостатки: Ш...
-
Исходные данные для расчета: 1. напряжение на выходе каскада = 2,5 В; 2. сопротивление нагрузки = 250 Ом; 3. нижняя граничная частота =120 Гц; 4....
-
Этот расчет проводим графоаналитическим методом. Графические построения проводим с помощью выходных и входных вольтамперных характеристик транзистора. На...
-
Полевые транзисторы с управляющим р-п переходом
Интегральные микросхемы на основе одних только полевых транзисторов с управляющим Р-п Переходом в настоящее время не выпускаются. В последнее десятилетие...
-
Биполярный транзистор с изолированным затвором IGBT
ВВЕДЕНИЕ Последнее время пристальное внимание разработчиков, в области силовой электроники, сконцентрировано на стремительном развитии последних...
-
Вывод, Список литературы - Полупроводниковые приборы, транзисторы
Действие транзистора можно сравнить с действием плотины. С помощью постоянного источника (течения реки) и плотины создан перепад уровней воды. Затрачивая...
-
Ключевой режим работы транзистора - Электроника и схемотехника аналоговых устройств
1. Транзисторный ключ с общим эмиттером Наибольшее распространение в цифровой и импульсной технике имеет ключ с общим эмиттером. В схеме - коллекторная...
-
Полупроводниковый резистор - это полупроводниковый прибор с двумя выводами, построенный на полупроводнике, равномерно легированном примесями. В...
-
Переключательные полупроводниковые приборы - Электроника и схемотехника аналоговых устройств
К переключательным полупроводниковым приборам относятся тиристоры, однопереходные и лавинные транзисторы. Тиристоры - это многослойные переключающие...
-
Элементы промышленной электроники - Общая электротехника и электроника
Выпрямители . Выпрямитель - это устройство, предназначенное для преобразования переменною напряжения в постоянное. В зависимости oт числа фаз питающего...
-
Микросхемы характеризуются следующими параметрами: Максимальное напряжение питания, Максимальное напряжение на входе и на выходе, Максимальный выходной...
-
Изучение характеристик логических элементов ТТЛ
Предварительные расчеты ,,,, , , , , , , , . Для схемы 1 1) напряжение отпирания транзистора Для кремниевых транзисторов напряжения отпирания равно 0.7В...
-
Типы полупроводниковых диодов - Исследование полупроводниковых диодов
Выпрямительные Диоды используют для выпрямления переменных токов частотой 50 Гц - 100 кГц. В них используется главное свойство p-n-перехода -...
-
Полупроводниковые диоды - Исследование полупроводниковых диодов
Полупроводниковый прибор с одним р-n-переходом, имеющий два омических вывода, называют полупроводниковым диодом (рис.1.4). Одна из областей р-n-структуры...
-
Инвертирующий сумматор - Разработка интегрирующего усилителя с выходным каскадом на транзисторах
Рис.1.2 Инвертирующий сумматор Разновидностью интегрирующего усилителя есть сумматор (рис.1.2), он позволяет получать на выходе суммарное напряжение,...
-
Полевые транзисторы - Электроника и схемотехника аналоговых устройств
Полевой транзистор - это полупроводниковый прибор, работа которого основана на модуляции сопротивления полупроводника поперечным электрическим полем...
-
Коммутаторы на полевых транзисторах - Аналоговые коммутаторы
Как известно, полевой транзистор в области малых напряжений сток-исток ведет себя как резистор, сопротивление которого может изменяться во много раз при...
-
Выбор усилительного полупровдникового прибора Сложность современных радиоэлектронных систем наряду со специфическими радиотехническими требованиями...
-
Принципиальная схема усилителя с межкаскадной КЦ второго порядка приведена на рисунке 8.1,а, эквивалентная схема по переменному току - на рисунке 8.1,б....
-
Рассчитываем элементы схемы автогенератора, Расчет ГУНа - Разработка радиопередающего устройства
Для улучшения стабильности частоты целесообразно выбрать контур с высокой добротностью (Qнен - добротность ненагруженного контура ) и большим...
-
Для целенаправленного изменения свойств полупроводники легируют, т. е. вводят в небольшом количестве атомы примесей, позволяющие управлять типом...
-
Мультивібратори на біполярних транзисторах - Мультивібратори
Мультивібратори на біполярних транзисторах більш за все виконують за симетричною схемою з колекторно-базовими зв'язками (рис. 1,а). Як і для тригера,...
-
Расчет элементов эквивалентной схемы - Разработка радиопередающего устройства
Резистивная и реактивная составляющая входного сопротивления транзистора Zвх=rвх+jXвх Zвх=2.131+j-0.112 Мощность возбуждения Коэффициент усиления...
-
Рис. 10. Усилитель мощности на основе повторителя - применена последовательная единичная ООС по напряжению (5.1) Операционный усилитель DA5 (рис. 10)...
-
Выбор оконечных транзисторов, расчет площади теплоотводов - Выбор трансформатора
Выходные транзисторы выбираем по предельно-допустимым параметрам: (А) (3.1) (В) (3.2) (Вт) (3.3) Выбираем 2 p-n-p транзистора [3]: VT8: КТ712А VT9:...
-
Источники сигнала и входные резисторы можно подключать и к не инвертирующему входу ОУ. (рис. 1.3) Рис.1.3 Не инвертирующий усилитель При замкнутой...
-
Измерение параметров элементов радиотехнических цепей (R, L, С, tgд=1/Q) - Оcновы радиоэлектроники
Метод вольтметра-амперметра Не требует специальных приборов (рис. 24). Рис. 24. Схема измерения комплексного сопротивления методом вольтметра-амперметра...
-
Напряжения питания выходного каскада выбирают из условия Е=Uнm + U, (2.1) Где U равно сумме минимального напряжения на источнике тока Iо (1-2В) и...
-
Схема усилительного каскада на полевом транзисторе с управляющими p-n-переходом и каналом р-типа показана на рисунке 5. Транзистор включен по схеме с...
-
Физика полупроводниковых структур - Основы микроэлектроники
В полупроводниках существует два основных механизма переноса носителей заряда: 1) Диффузия - направленное перемещение носителей заряда в кристалле в...
-
Целью данного курсового проекта является разработка интегрирующего усилителя с выходным каскадом на транзисторах и проведение графоаналитического расчета...
Элементы полупроводниковых ИМС на биполярных транзисторах